熱門關(guān)鍵詞: 高低溫試驗箱 恒溫恒濕試驗箱 步入式恒溫恒濕實驗室 高壓加速老化試驗箱 冷熱沖擊試驗箱
目前,國內(nèi)外對于IGBT器件失效的研究眾多,主要從兩方面入手,一方面是考慮器件自身的工作循環(huán),另一方面是考慮器件的實際工況環(huán)境,研究表明IGBT失效是由內(nèi)部工作循環(huán)及外部工況同時作用導(dǎo)致的,其失效機理復(fù)雜,失效模式主要分為封裝類失效及芯片類失效,如圖2-2所示。
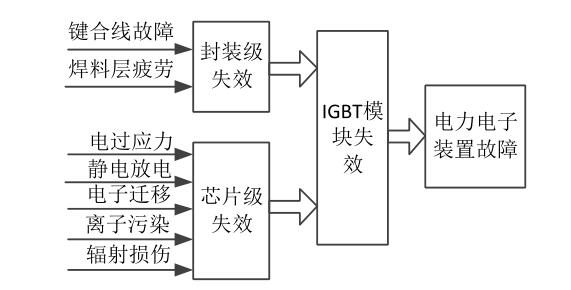
鍵合引線一般是通過超聲波鍵合工藝,實現(xiàn)與芯片、DBC板的連接,由于工作過程中承受較大的電流負載,其鍵合點處為IGBT模塊的薄弱環(huán)節(jié)之一。鍵合線故障主要包括鍵合點脫落及鍵合線斷裂,研究表明功率電子器件中鍵合線失效占器件總失效的70%左右。隨著技術(shù)發(fā)展,用于IGBT鍵合線的材料特性越來越好,鍵合線斷裂情況很少再發(fā)生,因此IGBT鍵合線故障主要的失效模式為鍵合點脫落。鍵合線脫落如圖(a)、(b),由于鋁鍵合線的抗拉極限低,在IGBT正常工作時的功率循環(huán)與溫度循環(huán)下,因電流通過產(chǎn)生的熱應(yīng)力及材料間CTE差異引起的剪切應(yīng)力,導(dǎo)致鍵合線與芯片連接處萌生裂紋,在持續(xù)的熱應(yīng)力或外部環(huán)境如振動沖擊影響下,裂紋擴展,進而導(dǎo)致IGBT鍵合線脫落。
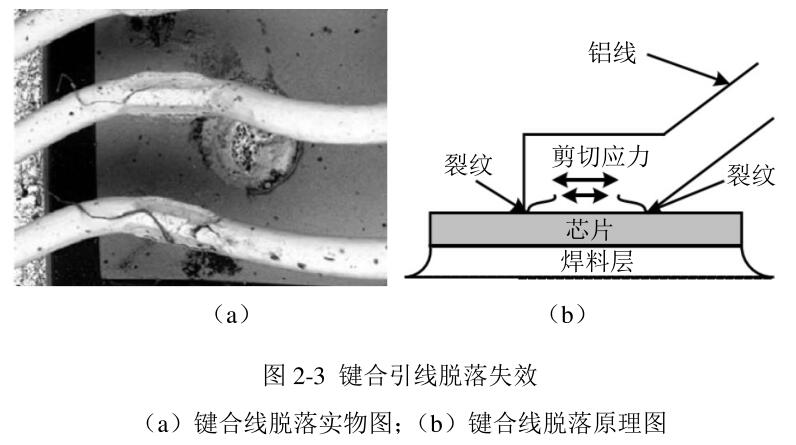
鍵合引線在剪切應(yīng)力作用下裂紋擴展失效的過程如圖2-4 所示,可以看到裂紋萌生的部位產(chǎn)生了應(yīng)力集中效應(yīng),導(dǎo)致靠近裂紋位置的應(yīng)力(σlocal) 要明顯大于其它距離裂紋位置較遠的應(yīng)力(σ),兩應(yīng)力之間存在如式(2-1)所述關(guān)系式。圖2-4中: a表示當(dāng)前形成的裂紋長度,r 表示到當(dāng)前形成裂紋尖部的距離大小。可以看到,σloca 應(yīng)力隨著到裂紋尖部的距離增大而呈現(xiàn)減小趨勢,當(dāng)某一靠近裂紋的位置出現(xiàn)σloca應(yīng)力大于鋁鍵合引線產(chǎn)生的應(yīng)力時,裂紋變形將發(fā)生擴展,進而導(dǎo)致鋁鍵合引線與IGBT 芯片間發(fā)生脫落。同時,如果需要確定裂紋變形區(qū)域的寬度,我們可以在式(2-1) 和式(2-2) 中假定σloca=σy,,然后求解即可。

焊料層主要作用在于連接IGBT器件內(nèi)部各層材料,在工作期間產(chǎn)生的熱循環(huán)過程中,由于材料間CTE差異,在材料間產(chǎn)生交變的剪切熱應(yīng)力,焊料層疲勞如圖2-5 (a)、 2-5 (b)所示。在上述應(yīng)力的連續(xù)作用下,導(dǎo)致焊料層疲勞老化,萌生裂紋,進而擴展至材料分層,同時由于裂紋及分層的產(chǎn)生,焊料層與各層材料間的接觸面積變小,模塊熱阻增大,IGBT 器件內(nèi)溫度進一步升高,并加速焊料層的失效,循環(huán)往復(fù),致使IGBT過熱燒毀。另一方面,不可避免的IGBT在制造過程中由于其工藝本身缺陷,其初始狀態(tài)就具有裂紋或空洞等,這些工藝缺陷在熱應(yīng)力的激發(fā)下,同樣將導(dǎo)致器件的失效。
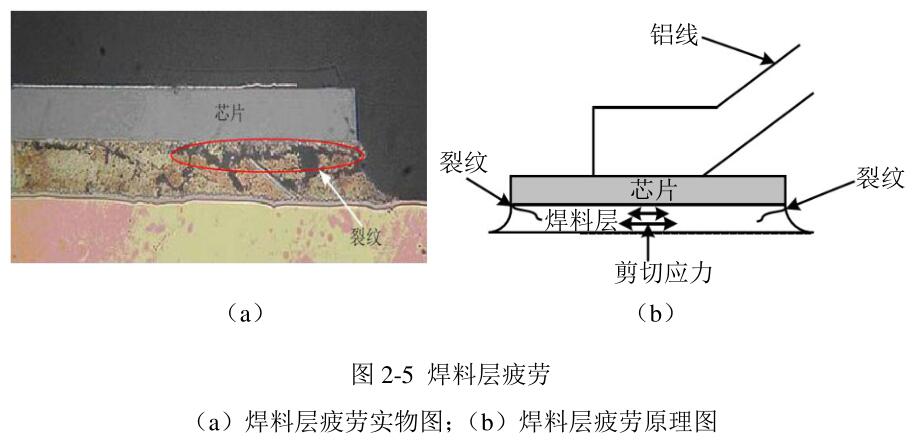
IGBT器件焊料層疲勞的擴展過程與鍵合引線裂紋擴展類似,如圖2-6所示。上圖所示熱剪切應(yīng)力作用下,焊料層疲勞裂紋末端產(chǎn)生一個不可恢復(fù)區(qū)域,同時在熱應(yīng)力作用下,裂紋發(fā)生拉長,致使焊料層生成一個包含可恢復(fù)變形( △ael )和永久變形( △apl )新的表面。在應(yīng)力σ去除后,前面形成的可恢復(fù)變形將復(fù)原,但永久變形部分仍在,致使新生成的表面發(fā)生擴展。

本文標(biāo)簽: IGBT器件 溫度循環(huán)試驗
溫濕度試驗箱 新聞資訊 產(chǎn)品 關(guān)于瑞凱 解決方案 聯(lián)系瑞凱 合作案例 網(wǎng)站地圖
 客服微信
客服微信400電話